-
E-mail
frank.yang@acuitik.com
-
Phone
13817395811
-
Address
4th Floor, No. 298 Xiangke Road, Pudong New Area, Shanghai
Product Categories
Suzhou Xishi Technology Co., Ltd
Semiconductor thin film non-contact thickness gauge
NegotiableUpdate on 02/09
- Model
- Nature of the Manufacturer
- Producers
- Product Category
- Place of Origin
Overview
The NS-30 semiconductor thin film non-contact thickness gauge is a high-precision measuring device based on the principle of white light interference, which is particularly suitable for scenarios that require automated measurement and accurate thickness distribution analysis.
Product Details
The NS-30 semiconductor thin film non-contact thickness gauge is a high-precision measuring device based on the principle of white light interference, which is particularly suitable for scenarios that require automated measurement and accurate thickness distribution analysis.
1. Core principle
The vertically incident high stability wideband light is incident on the surface of the sample, causing optical interference between the various film layers. The reflected light can be analyzed by spectroscopy and regression algorithms to calculate the thickness of each layer of the film. Suitable for measuring the thickness, reflectivity, refractive index, and other parameters of transparent or semi transparent film layers ranging from nanometer to micrometer levels.
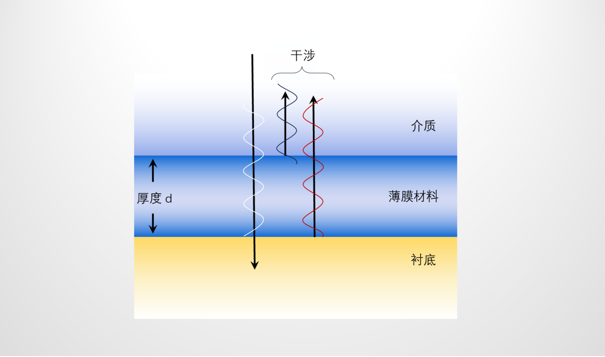
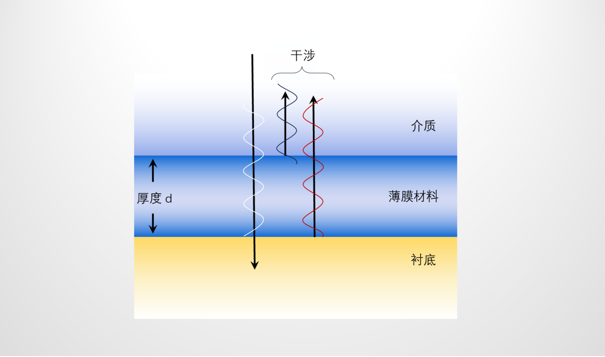
2. Specific parameters
-Core principle: Vertical incidence wideband white light interferometry technology
-Measurement range: 1 nm to 250 μ m
-Wavelength range (NIP model): 950 nm -1700 nm (near-infrared band)
-Accuracy: 3 nm or 0.4%
-Repetition accuracy: 0.1 nm
-Measurement speed:<1 second/single point
-Spot size: 1.5 mm
-Core feature: Automatic sample stage, capable of preset point positions for automatic measurement, and generating 2D/3D distribution maps of thickness, refractive index, and reflectivity
-Sample table size: 100mm to 450mm optional
-Measurement capability: capable of measuring the thickness, refractive index (n), and reflectivity of each layer of multi-layer composite films
3. Core functions


4. Display of actual test results
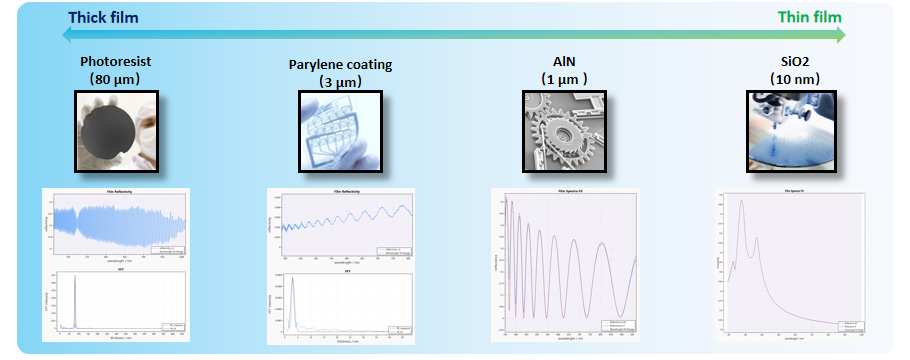
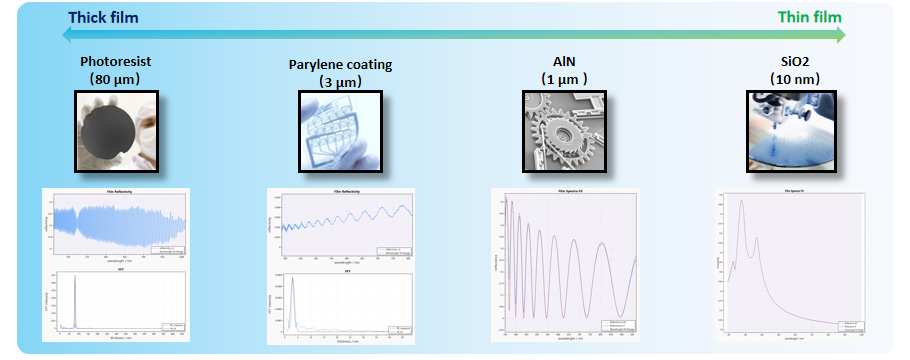
Similar Product Recommend





